적용사례
Wafer Probe Card
열변형 및 밀림현상 해석
열변형 및 밀림현상 해석
해석배경
Probe Card는 전자 테스트 시스템과 반도체 웨이퍼 사이의 인터페이스로 인쇄 회로 기판(PCB)과 일부 형태의 접촉 요소로 구성됩니다. Probe Card는 Wafer Prober에 삽입되며, 그 내부에서 Prober와 Wafer 사이에 접촉에 정확하게 이루어지도록 Wafer의 위치를 조정하며 실험을 진행합니다. 이때 Probe Card의 효율은 Probe Card와 Wafer사이의 접촉부를 변형 시킬 수 있는 여러 요인 중 온도로 인한 변형과 이로 웨이퍼의 밀림현상 중점으로 분석합니다.
해석목적
• Wafer Probe Card의 열변형 평가 및 정밀도 확보
• Wafer의 밀림현상 해석

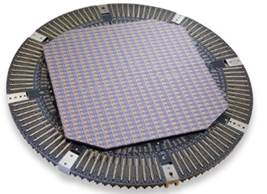
해석모델 및 해석조건
Wafer Probe Card열 해석
• 절점온도 : 90℃
• 외기온도 : 20℃
• 자연대류 경계조건 적용
• 하중조건 :
- 각 Hole에 10g 하중적용
- 전체 절점에 대하여 각 절점의 온도하중 적용
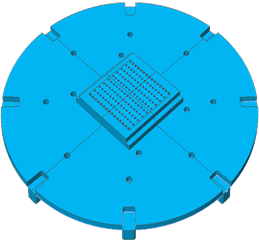
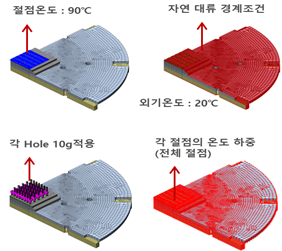
Wafer 선형정적해석
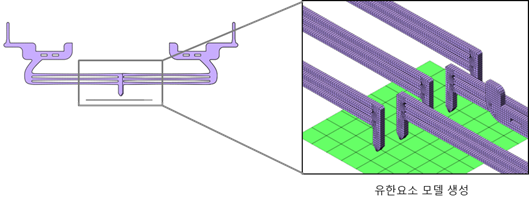
해석결과
Wafer Probe Card 열응력/열전달해석
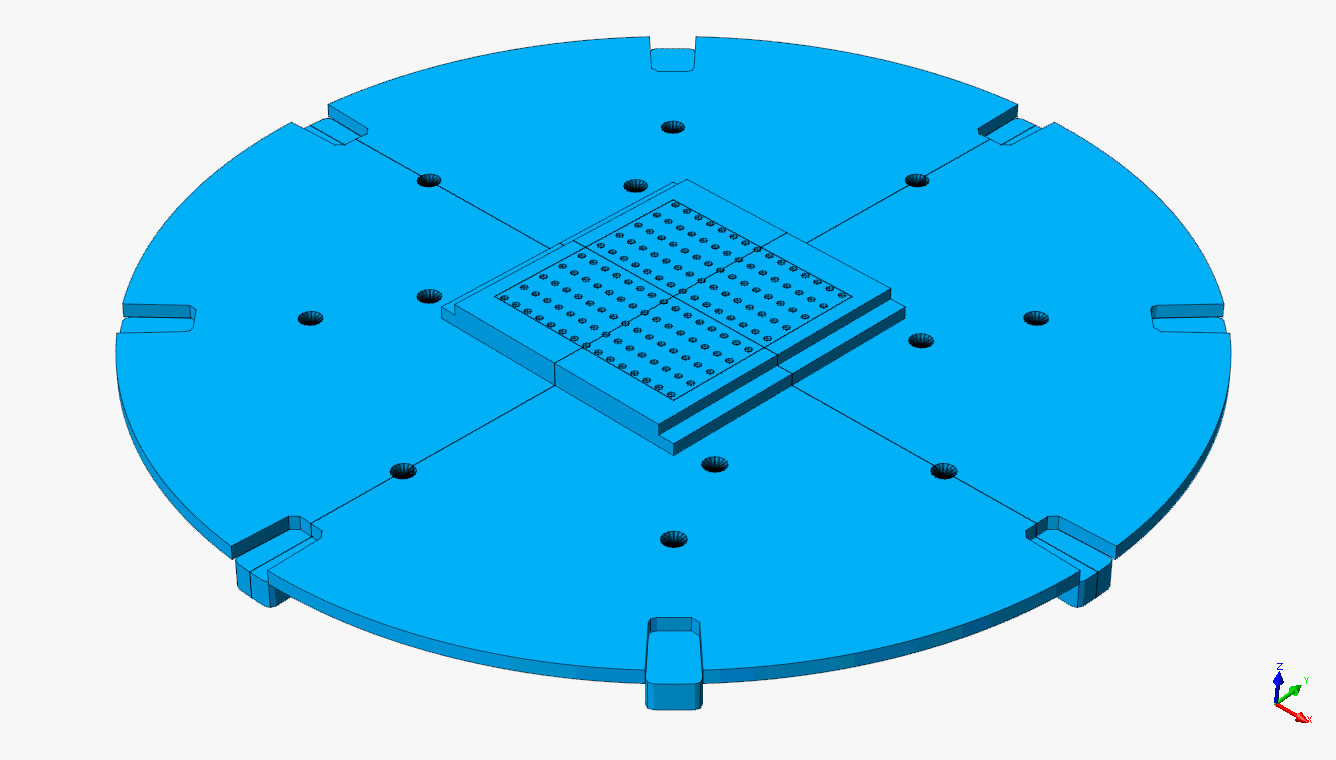

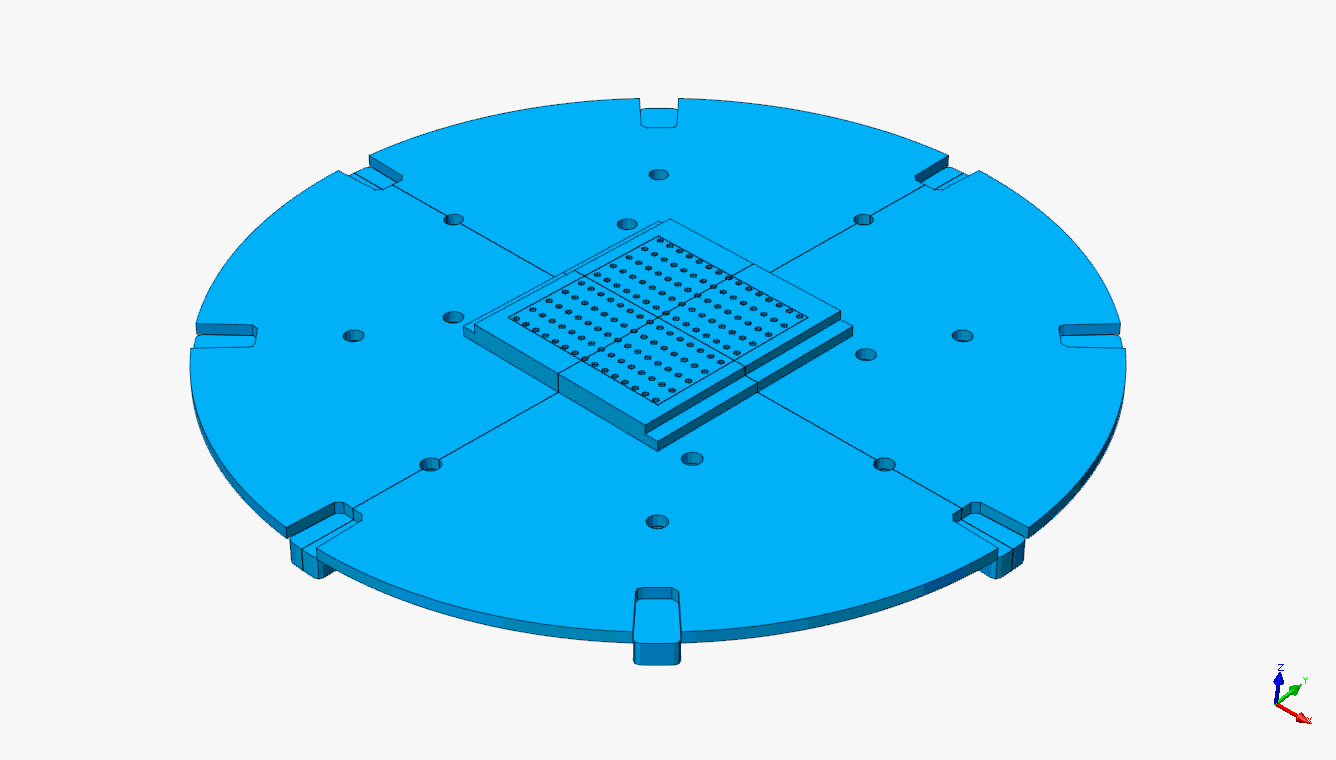

Wafer 선형정적해석